当芯片制程逼近物理极限,晶体管密度以亿为单位在方寸之间堆叠,一个曾经“不起眼”的问题正成为扼住先进制程咽喉的关键——热。
指甲盖大小的晶粒上,热点可能只有几微米,却能在毫秒间引发热失控,导致价值数十万的晶圆废片。传统检测手段的困境在于:热电偶太慢且损伤样品,电子显微镜虽准却无法在线,而常规热像仪又“看不清”微观世界的温差。
正是在这一技术真空地带,格物优信X1280D系列红外热像仪以“百万像素+微距光学”的组合拳,为芯片晶圆测温开辟了非接触、实时化、微观化的新路径。
一、 不止于“看见”,而是“看清”微米级热分布
芯片晶圆测温的第一道坎,是空间分辨率。
常规热像仪即便像素达标,若无合适的光学系统,面对数百微米的焊球、数十微米的导线,也只能得到一片模糊的热斑。X1280D系列的核心突破在于“软硬协同”:
硬件层面,其采用1280×1024大面阵探测器,131万像素奠定了高清的底子,12μm小像元带来了高空间分辨率。更重要的是,它可定制搭载4.8μm微距镜头,实现对焦距离仅数毫米,最小可清晰识别3微米级别的目标。对于晶圆上的微小电容、Bump(凸点)乃至裸芯片内部结构,不再是“看不全”,而是“纤毫毕现”。
算法层面,针对半导体材料的复杂性——硅的低发射率、树脂封装的高发射率、金属焊球的反射干扰——X1280D支持发射率逐点可调与专业校准算法,避免因材质差异导致的测温“漂移”。
二、 从“单点滞后”到“全场瞬态”
晶圆测试、芯片上电验证等场景中,故障往往发生在通电瞬间。短路引起的局部发热,可能在几十毫秒内达到峰值;若热像仪帧率不足,这一瞬态热点就会被“漏掉”。
X1280D系列在维持30Hz全帧温度输出的同时,针对高速瞬态场景可适配更高帧频机型,实现毫秒级响应。与过去依赖热电偶的“单点粘连、逐个测量”相比,其优势是降维打击式的:
无损伤:非接触测温,彻底消除探针划伤、拆线短路风险;
全视场:一次性获取整个视场内数万至百万个像素点的温度数据,热点无处遁形;
动态捕捉:可实时追踪芯片从冷启动到稳态的全周期温度曲线。
某实验室工程师曾感慨:“过去测一块芯片的温度分布,像盲人摸象;现在打开热像图,哪里发热,一目了然。”
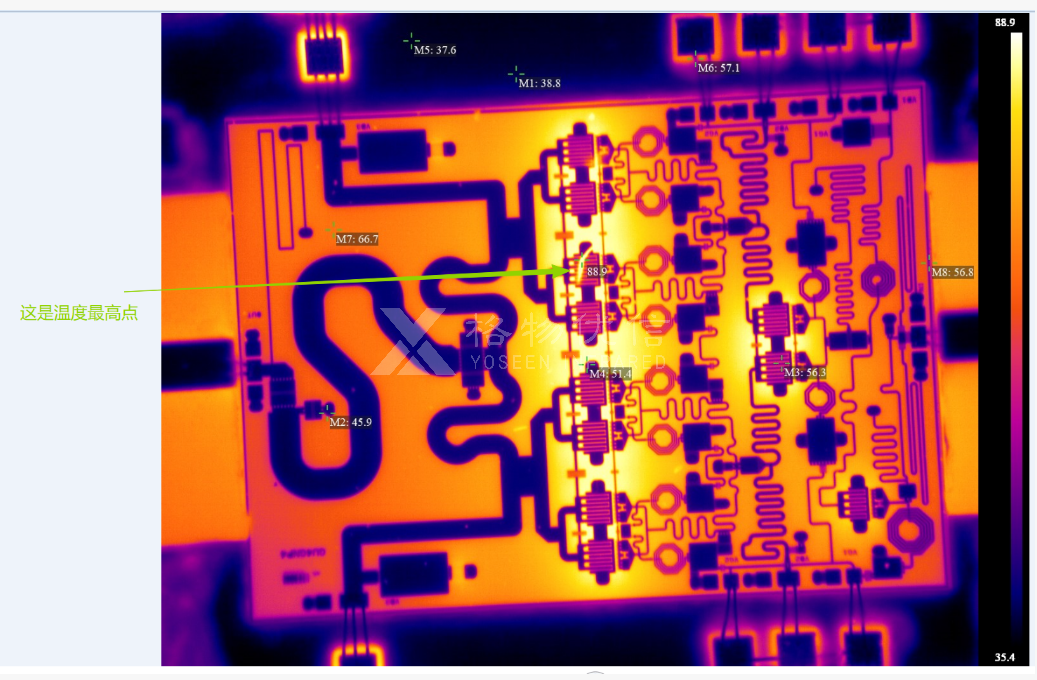
三、 不仅是工具,更是“数据入口”
智能制造的底层逻辑,是将物理世界的缺陷转化为数字世界的可分析信号。X1280D系列的价值不仅在于成像,更在于其开放的数据架构。
它提供全辐射温度流输出,每一帧图像的每一个像素都携带真实的温度数值,而非仅仅是渲染后的伪彩图。配合IRStudio科研级分析软件,工程师可进行:
离线逐帧分析:回放测试过程,定位毫秒级异常节点;
多曲线叠加:对比不同设计版图下的热分布差异;
二次开发集成:SDK支持跨平台调用,无缝嵌入自动化测试机台(ATE)或良率管理系统。
这意味着,X1280D不再是一台孤立的仪器,而是晶圆级热特性大数据系统的前端感知单元。从研发阶段的失效分析,到量产产线的在线抽检,热数据真正流动了起来。
四、 国产高端热像仪的“科研自信”
过去,高端科研与半导体检测领域长期被进口品牌垄断。而格物优信X1280D系列的突围,折射出国产热成像技术的两个关键跃升:
一是像素级对标。1280×1024分辨率、12μm像元已跻身国际一线梯队,在微距热成像这一细分赛道实现并行。
二是场景深耕。不是卖通用设备,而是针对芯片测温专门优化微距光路、发射率模型与触发机制,甚至为高校研究院提供定制化支架与方案。
目前,该系列已进入多家高校及芯片研发机构,在材料热效应研究、功率器件缺陷定位等场景落地。
芯片的竞争,归根结底是精度的竞争;精度的竞争,始于量测技术的边界。当3nm、2nm制程不断逼近物理极限,晶圆内部的热行为将愈发复杂而敏感。格物优信X1280D系列的价值,正是在于它把红外测温的视野从“宏观设备维护”推进到了微观工艺控制的无人区。






